本實用新型屬電子技術領域.特別是涉及一種尺寸結構予以小型化的金屬封裝晶振.
隨著消費性電子產品(如手機,MP3等)的迅速發展.以及IC智能卡應用的普及.制造廠商提出更加小型化的晶振需求.先前產品已經不能滿足顧客需要.雖然金屬封裝晶振的體積較小.但其價格較為昂貴.開發一種體積小.成本低的封裝貼片晶振具有廣闊的前景.
該篇文章主要所講的是關于實用新型所要解決的技術問題是提供小型化的超小型金屬封裝晶振.來滿足消費性電子產品市場的應用需求.應用新型解決其技術問題所采用的技術方案是提供一種金屬封裝石英晶振.包括基座和上蓋.所述的基座為陶瓷基座.所述的上蓋為金屬上蓋.基座內部置入鍍銀電極水晶芯片.以導電膠將芯片黏著在基座內部電極上.內部電極線路連接著基座外部電極.通過陶瓷基座上的金屬環將基座及上蓋進行封合.所述的金屬封裝晶振的體積為2016MM晶振.有益效果小型化金屬封裝晶振的體積為2.0X1.6X0.5mm.大幅降低了石英晶體諧振器體積.并保持了高頻率精度,穩定度及密封性.可廣泛應用于小型化的電子產品中.
具體實施方式
下面結合具體實施例.進一步闡述本實用新型.應理解.這些實施例僅用于說明本實用新型而不用于限制本實用新型的范圍.此外應理解.在閱讀了本實用新型講授的內容 之后.本領域技術人員可以對本實用新型作各種改動或修改.這些等價形式同樣落于本申 請所附權利要求書所限定的范圍.本實用新型包括基座和上蓋.基座為陶瓷基座1.上蓋為金屬上蓋2. 基座內部置入鍍銀電極水晶芯片3.以導電膠4將芯片黏著在基座內部電極上.
內部電極線路連接著基座外部電極.通過陶瓷基座上的金屬環將基座及上蓋進行封合.金屬封裝貼片晶振的體積為2.0X1.6X0.5mm.下面是開發前后晶振尺寸對比晶振體積(mm3)開發前后體積比開發后(2.0*1.6*0.5)開發前3225晶振
1.一種金屬封裝晶振.包括基座和上蓋.其特征在于所述的基座為陶瓷基座
(1).所述的上蓋為金屬上蓋
(2).基座內部置入鍍銀電極水晶芯片
(3).以導電膠
(4)將芯片黏著在基座內部電極上.內部電極線路連接著基座外部電極.通過陶瓷基座上的金屬環
(5)將基座及上蓋進行封合.
2. 根據權利要求1所述的一種金屬封裝晶振.其特征在于所述的金屬封裝晶振的體積為2.0Xl.6X0.5mm.
專利摘要本實用新型涉及一種金屬封裝晶振.包括基座和上蓋.所述的基座為陶瓷基座
所述的金屬封裝晶振的體積為2016MM晶振.本實用新型大幅降低了晶體諧振器體積.并保持了高頻率精度,穩定度及密封性.可廣泛應用于小型化的電子產品中.該篇文章康比電子主要所講的是關于實用新型所要解決的技術問題是提供小型化的超小型金屬封裝晶振.來滿足消費性電子產品市場的應用需求.應用新型解決其技術問題所采用的技術方案是提供一種金屬封裝石英晶振.


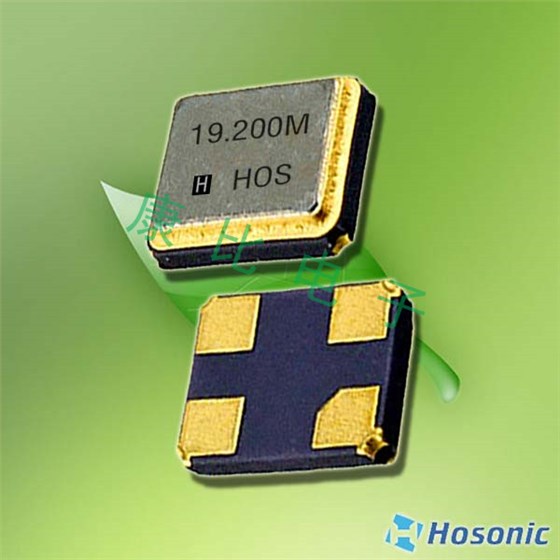
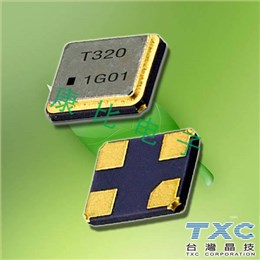 TXC晶振,貼片晶振,7M晶振
TXC晶振,貼片晶振,7M晶振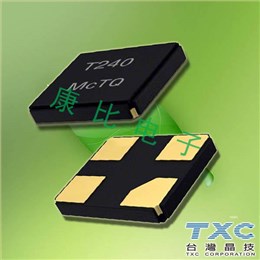 TXC晶振,貼片晶振,7S晶振
TXC晶振,貼片晶振,7S晶振 TXC晶振,貼片晶振,7A晶振
TXC晶振,貼片晶振,7A晶振 微晶晶振,32.768K晶振,CM9V-T1A壓電石英晶體
微晶晶振,32.768K晶振,CM9V-T1A壓電石英晶體




